
故障解析とは
半導体故障解析(Semiconductor Failure Physical
Analysis)とは、半導体デバイスの故障原因を物理的な観点から調査し、特定するプロセスです。
故障解析は、故障のメカニズムを理解し、デバイスの信頼性を向上させるために重要です。
ネクスティエレクトロ二クスでは、半導体メーカーで実施される一般的な故障解析手法に則り、故障原因を調査します。
ネクスティ エレクトロニクスの故障解析サービス
多岐にわたる半導体デバイスの故障の中でも、EOS(電気的オーバーストレス)やESD(静電気放電)要因による故障は、よくみられる故障です。
各メーカーのデバイスのデータシートには、一瞬でも超えてはならないMAX値として絶対最大定格が記載されていて、その絶対最大定格を超える電圧、電流が印加された際に、デバイスが破壊され、EOS/ESD故障となります。
EOSやESD故障は、メーカー保証外のストレスが印加されたということからメーカーでの解析依頼を受け付けてもらえないケースが多々あります。
そのような場合、ネクスティエレクトロ二クスでは、半導体メーカーで実施される一般的な故障解析手法・解析装置を使用し、EOS/ESDの故障解析調査を実施します。
EOS/ESD故障の他、故障解析を通して判明した内容によって、故障原因を推測します。 (下記、故障解析項目参照)
故障解析項目

故障解析のプロセス
外観観察
パッケージ外観の異常を観察
解析対象サンプルを受け取った後、まずは外観の異常を確認し、キズ、クラック、変色、異物の付着等の異常の有無を観察します。
また、パッケージの寸法測定も可能です。
機材:マイクロスコープ KEYENCE VHX-5000
-

パッケージ表面観察
-

パッケージ測長
-
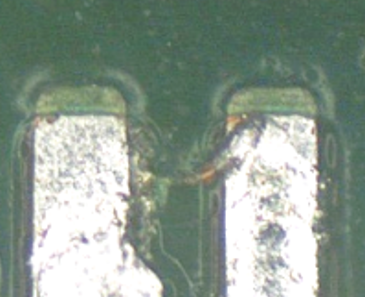
リード間の異物付着
機材:レーザー顕微鏡 KEYENCE VK-X200
レーザー顕微鏡による表面形状、粗さ測定も対応しています。
1.パッケージ中央に膨れを確認し、レーザー顕微鏡で測定。
2.パッケージの膨れを3D画像化。中央部に膨れを確認。


▼
X線観察
パッケージ内部の異常を観察
X線観察により、非破壊で内部の異常を確認することが可能です。 ワイヤ流れ、焼損、ワイヤ切れ、ワイヤクラック、エッジタッチ、異物の混入など、外観からは見えないPKG内部の異常の有無を確認します。
機材:X線装置 Nordson DAGE QUADRA5
-

チップ&ワイヤ焼損
(EOSによる破壊) -

ワイヤが隣接するワイヤと接触
-

ネック部にクラックが発生し
断線
-

ワイヤが変形しチップのエッジに
触れている -
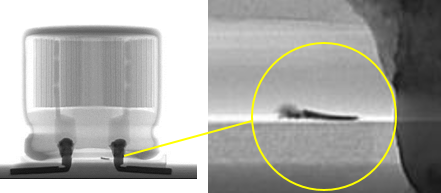
異物混入アルミ電解コンデンサ直下に観察された金属片の異物

▼
電気的特性測定
VI特性測定/抵抗値測定/容量測定/インダクタンス測定
VI特性測定では、ソースメーターを使用し、端子間のVI特性を測定し、リーク、ショート、オープンを確認します。
機材:ソースメータ KEITHLEY/2601B
-

VI特性測定図: 測定対象ピンへの電圧印可/電流測定
-

VI特性測定波形結果: 良品はダイオード特性が確認できるが、故障品はショート特性を示しており、故障と判断
-

WAYNE KERR/3260B
-

EX.コンデンサ容量測定結果
LCRメータ:抵抗、コンデンサ、インダクタの場合は、LCRメータを使用し、抵抗値、静電容量、インダクタンスを測定し、規格値との差異を確認します。

▼
SAT(超音波探査法)
パッケージ内部の剥離を観察
反射法
水中内に解析対象試料を入れて試料に超音波をあてると、試料からは反射波が返ってきます。
反射波は各材料がもつ固有の音響インピーダンス(音波の伝わりやすさ)の差が大きい程大きく反射されます。
試料は各材料から構成されているため、各材料が接する界面では音響インピーダンスに差が生じます。
反射法では、その性質を利用して各材料界面の剥離を観察します。
機材:INSIGHT/INSIGHT-300 保有プローブ:25MHz/50MHz/75MHz

動画:装置作動時
EX. SATによる剥離観察
パッケージ内部(ダイパッド界面)の画像化
一般的な構造のICパッケージでは、下記の界面を反射法で観察します。
①モールド/リードフレーム界面/②モールド/チップ界面/③モールド/ダイパッド界面

-

剥離なし時の反射波形:M字を示す
-

剥離あり時の反射波形: W字を示す
チップ/ダイパッド間(ダイアタッチ材の剥離を観察)は、透過法で観察します。
透過法
透過法では、材料を透過する超音波を検知し、剥離・ボイドの有無を観察します。
剥離・ボイド等の空気の層があると、媒質の密度は大きく低下するため、透過する超音波も大きく減衰し、画像上では黒く画像化されます

チップ/ダイパッド間透過画像:
-

剥離なし/チップ範囲に黒い影無し
-

チップ範囲及びダイパッド部にまで黒い影あり

▼
パッケージ開封&チップ表面観察
樹脂を薬液で開封する
最初にレーザー加工でモールド樹脂を薄く削った後、薬液によりパッケージ樹脂を溶解させ、チップ表面を露出します。
露出したチップ表面をマイクロスコープやSEMで観察し、
焼損、パッシベーション膜クラック、配線腐食、ボンディング形状等の異常がないか確認します。
QFP
Cuワイヤ品開封
※Cu/Agワイヤは従来の薬液処理のみでは溶解してしまう為、ワイヤを観察したい場合は事前にレーザー加工により不要な樹脂を除去し、薬液とワイヤとの接触時間を短縮することで
ワイヤへのダメージを最小に抑え開封いたします。
-
レーザー開封
-
薬液開封
-

EOSによるチップ焼損
-
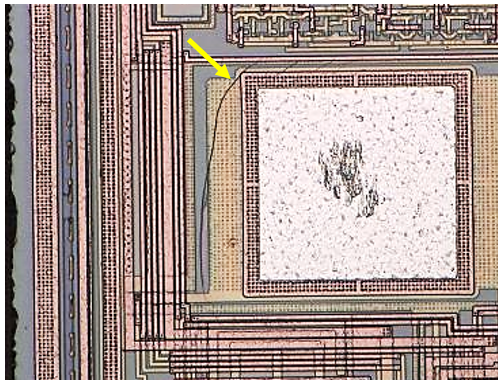
パッシベーション膜クラック
水晶振動子の開封
モールド樹脂の他、金属パッケージ等の機械的な開封にも対応します。

研磨により金属パッケージを薄膜化し開封

▼
IR-OBIRCH解析
チップの不具合箇所を特定
電気的にはショート、リーク、高抵抗等の異常が確認されているが、チップ表面上に異常が観察されない、そのような時は、チップ表面層より下層に異常がある可能性があります。
IR-OBIRCHでは、上記の様な異常のあるチップに定電圧を印可した状態でレーザー波長1.3μmのレーザー光を走査します。
異常箇所は正常箇所に比べ、レーザーの加熱による抵抗変化が顕著になります。
その抵抗値の変化を電流値として検出し、レーザー走査と電流値を同期させることで異常箇所を特定します。
機材:IR-OBIRCH装置 浜松ホトニクス PHEMOS-1000
-
OBIRCH装置作動時
IR-OBIRCHによる異常箇所特定: Si基板裏面より観察
機材:裏面研磨器 ULTRA TEC
チップ上層のメタル配線の影響(メタル配線の厚みや多層等)により下層の配線や回路素子へレーザーの熱が届きにくいケースでは、裏面研磨器を使用し、Si基板裏面を露出させ、
裏面から透過観察及びレーザー加熱することにより、異常箇所を特定する事も可能です。
(※レーザー波長1.3μmの光は、Siを透過するという特徴がある。)
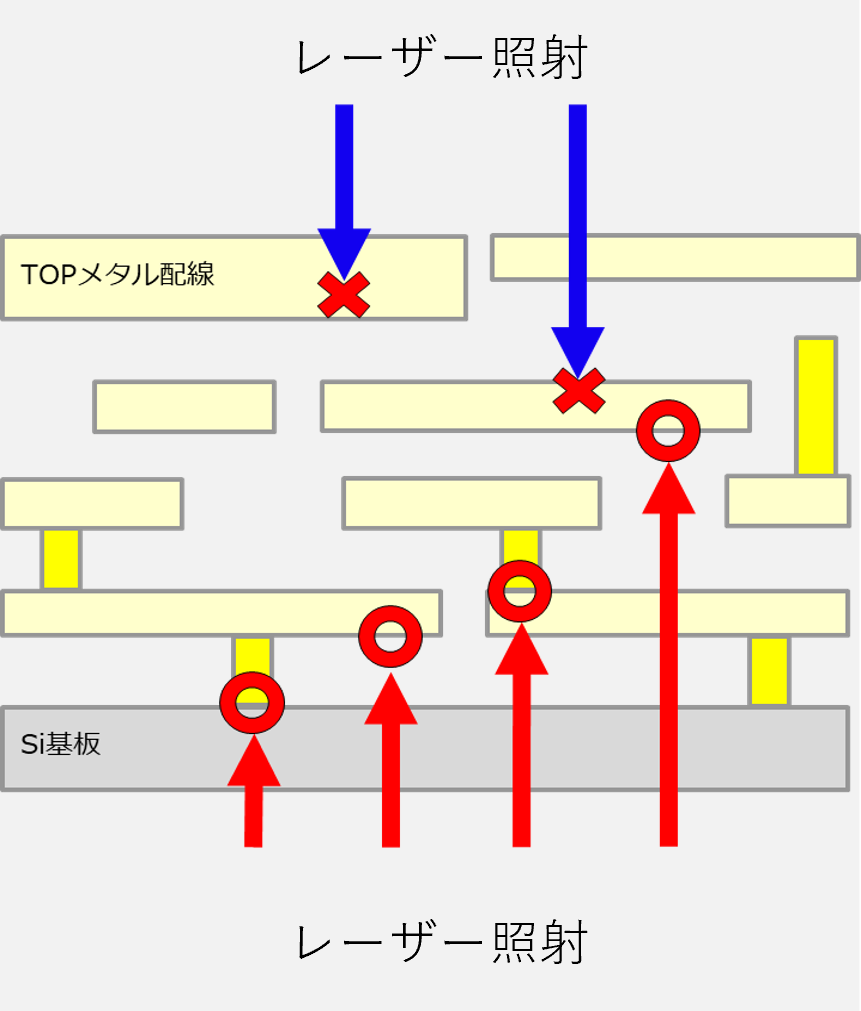
裏面研磨後パッケージ
パッケージ裏面より、ダイパッドを削り、Si基板の裏面を露出
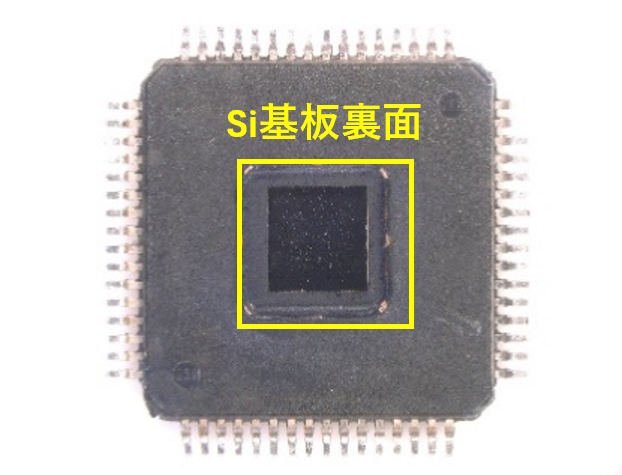

▼
報告書提出
ご依頼の流れ
お問い合わせ、お見積りは無料です。
ネクスティ エレクトロ二クスが取り扱う商材以外のデバイスでもご利用可能です。
ご興味をもっていただけましたらどなたでもお気軽にお問い合わせください。
1. お問い合わせ
お問い合わせフォームから、ご依頼内容、ご依頼のサンプル情報、個数、予算、希望納期をお知らせください。
お客さまで解析やご依頼に関する資料などお持ちでしたら、ご一緒に送付ください。※サンプル情報やご予算は公開可能範囲で構いません。
2. お問い合わせへの回答とヒアリング・お見積り
ネクスティ エレクトロニクスの担当者より、お問い合わせ、ご依頼の詳細をヒアリングさせていただきます。
ヒアリング中に解析内容の確認、解析の可否、その他ご要望等を確認し、
お見積りと納期を確認の上、ご連絡いたします。
解析内容、お見積り、納期をお客さまでご検討いただき、正式に発注いただける場合に、正式お見積りを送付いたします。
3.ご依頼の発注と解析サンプルの送付
お客さまより、ご依頼の注文書を送付いただきます。注文書受領後に、解析作業を開始します。
解析サンプルの送付先は、ネクスティ エレクトロニクスよりご連絡します。
4. 解析作業開始
ご依頼の解析を行います。
解析途中の結果が欲しい場合は、中間報告の対応も可能です。
・非破壊解析から破壊解析に移る前に一度報告が欲しい
・解析個数が多い場合、途中でも取り急ぎ解析結果を知りたい など
5.解析結果のご報告
解析結果を報告書にまとめ、お客さまへ送付します。
結果についての不明点や、質問などがあった際は、お気軽にご質問ください。
6. お支払い処理と解析サンプルのご返却
お客さまにて検収後に、ネクスティ エレクトロニクスより解析サンプルと請求書・受領書・納品書を送付します。
お支払い処理をお願いいたします。
お問い合わせ
ご相談、ご質問、お見積り依頼などを、下記のボタンより受け付けています。
ネクスティ エレクトロ二クスが取り扱う商材以外のデバイスでもご利用可能です。
お見積り依頼の場合は、下記の項目を記載いただくとスムーズです。
記載がない場合もご案内させていただきますので、お気軽にお問い合わせください。確認次第、担当者より回答します。
お見積り依頼記載項目:
ご依頼内容:
ご依頼のサンプル情報:
個数:
予算:
希望納期:
対応拠点のご紹介
愛知拠点TAQS(Toyotsu Automotive Quality Support Center)
| 所在地 | 〒446-0004 愛知県安城市尾崎町大縄1-3 |
|---|---|
| 対応サービス | 故障解析、 良品解析、 信頼性試験:加速試験、 断面解析 |

ネクスティ エレクトロ二クスのVAセンター部は、東京のVAC (Value Adding Center)、愛知県のTAQS(Toyotsu Automotive Quality Support
Center)の2拠点で、お客様へ品質・解析サービスを提供しています。
お客様に必要なサービスを行える拠点で対応させていただきますので、ご要望があればまずはボタンよりお問い合わせください。

品質・解析サービス拠点のポイント
ネクスティ エレクトロ二クスのVAセンター部では、下記の通り万全の体制で、ご安心いただける品質・解析サービスを提供しています。
- 建物設備
万全な耐震設備
- セキュリティ
監視カメラモニター、入退室管理
- 作業環境
温度・湿度管理、静電対策












